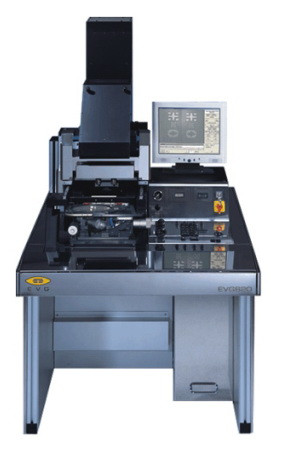
- Основные
- Производитель
- Страна производительАвстрия
Описание:
Установки серии EVG 620 - это установки прецизионного двухстороннего совмещения и экспонирования для подложек диаметром до 150 мм. Кроме стандартной литографии с верхней и нижней сторон и возможности прецизионного совмещения пластин для их скрепления, установки серии EVG620 могут применяться в области нанотехнологий, например, для переноса рисунка со штампа на подложку для микроконтактной печати и литографии для получения нанооттисков. Оба этих процесса могут использовать прецизионные микроскопы установки EVG620 для оптического совмещения оттисков. Прецизионные системы совмещения EVG620 приспособлены для создания оттисков с штампами и подложками с размерами от маленьких кристаллов до диаметров 150 мм
- Все методы экспонирования стандартны, включая режимы мягкого, жесткого экспонирования, вакуумный контакт и экспонирования с микрозазором. Для режимов вакуумный контакт и экспонирования с микрозазором не требуется специальных приспособлений
- Прецизионная точность совмещения (до 1 мкм)
- Уникальная система клиновой компенсации на воздушных подшипниках
- Верхний микроскоп с раздельной областью наблюдения с матрицей объективов либо с одиночным объективом
- Совмещение по нижней стороне с помощью двух CCD-камер и монитора с высоким разрешением
- Стандартное совмещение по верхней стороне с помощью CCD-камер
- Стандартные объективы для верхнего и нижнего микроскопов (от х3.6 до х20)
- Оптическое совмещение пластины с шаблоном
- Совмещение одиночных кристаллов посредством микроскопа с раздельной областью наблюдения (минимальное расстояние до объектива 8 мм)
- Микропроцессорное управление совмещением и экспонированием с сохраненными параметрами технологического процесса и положением объектива нижнего микроскопа
- Совмещение (X, Y и θ) посредством микрометров с приводом на постоянном токе или прецизионных микрометрических шпинделей
- Используемая передовая технология совмещения обеспечивает массу преимуществ над обычными узлами совмещения
- Обеспечение безвибрационного совмещения
- Минимально возможное контактное усилие между маской и подложкой. Микропроцессорный контроль для защиты маски и фоторезистивной поверхности
- Контактное усилие не зависит от веса подложки
- Заменяемые проставки для работы с различными толщинами подложек до 10 мм
- Моторизированный привод перемещения по оси Z для регулировки расстояния между маской и подложкой для совмещения и экспонирования с микрозазором
- Точное регулирование времени экспонирования
- Внешний блок питания ламп для полной изоляции механизма совмещения от вибраций
- Эргономичный дизайн для удобной работы
- Большая область перемещения верхнего и нижнего микроскопов для гибкого применения
- Компактность. Виброизоляционный столик (опция)
- Минимальное количество движущихся частей в рабочей зоне и управляемый поток чистого воздуха обеспечивают очень низкую степень загрязнения
- Высокие стандарты качества и надежности всех компонентов
- Все компоненты проходят контроль качества при установке
- После окончательной сборки проводится 48 часовой автоматический тест работоспособности установки
- Модульная конструкция обеспечивает минимальное время простоев
Технические характеристики
|
Параметры пластины/подложки: |
|
|
Размер: |
Ø2"-150мм, до 100 мм х 100 мм (опционально до 150 мм х 150 мм) и отдельные компоненты (например, отдельные кристаллы) |
|
Толщина: |
Устройство совмещения маски: 0.1-10 мм (максимум до 2 мм для совмещения по нижней стороне) Устройство совмещения для соединения пластин: 0.1-3 мм для каждой пластины или подложки, максимальная величина сборки до 4.5 мм |
|
Размер маски: |
Максимум 7", толщина: < 6.35 мм |
|
Совмещение: |
Область совмещения: X, Y, Z: ± 5 мм Поворот: θ ± 30 Все перемещения выполняются полностью моторизовано, с управлением от 3-осного джойстика или посредством высокопрецизионных микрометров. Точность перемещения по осям X, Y, θ: 0.6 мкм |
|
Точность совмещения: |
Узел совмещения маски: 0.5 мкм для совмещения по верхней стороне (с 20х объективами), 1 мкм для совмещения верхней поверхности относительно нижней (с 20х объективами) Узел совмещения для соединения пластин: 0.5 мкм для стекло/кремний, 1 мкм для кремний/кремний |
|
Система перемещения: |
3-осный робот, отправка, транспортировка, получение и выгрузка кассет, 100 мм – 150 мм пластины, опционально 2" – 100 мм |
|
Точность робота: |
± 25 мкм |
|
Производительность: |
150 пластин в час |
|
Точность станции пресовмещения: |
X: ± 50 мкм, Y: ± 50 мкм, θ: ± 0.090 |
|
Автоматическое совмещение: |
Точность: <0.5 мкм с 10х объективами и заданными реперными знаками |
|
Регулировка расстояния/микрозазора: |
Расстояние: Диапазон регулировки максимум 300 мкм с шагом в 1 мкм (разрешение перемещения по оси Z – 0.33 мкм) с управлением от микропроцессора |
|
Контактное усилие: |
Между маской и подложкой для клиновой компенсации: узел совмещения маски: регулируется от 0.5 до 40 Н узел совмещения для соединения пластин: регулируется от 1 до 40 Н |
|
Разрешение печати: (350-450 нм, 150 ммпластины) |
Мягкий контакт: контактное усилие: 2 Н: < 2 мкм 10 Н: 1-1.5 мкм Жесткий контакт: 300 мбар: 0.8 – 1.5 мкм Микрозазор: 5 мкм: 1-2.5 мкм; 10 мкм: 1.5 – 3 мкм; 15 мкм: 1.8 – 3.5 мкм; 30 мкм: 2.5 –5 мкм Вакуумный контакт: 0.6 мкм |
|
Монитор/камера: |
Черно-белые CCD-камера и монитор с высоким разрешением |
|
Экран лампы: |
Стандартно УФ-лампы с длиной волны 350-450 нм (опционально: УФ-лампы с длиной волны 240-350 нм) |
|
Однородность УФ-излучения: |
100 мм: ± 2%; 150 мм: ± 4% |
|
Интенсивность (измерено при длине волны 365 нм для 100 мм и 150 мм): |
350 Вт: 15-20 мВт/ см2 500 Вт: 20-25 мВт/ см2 1000 Вт: 30-45 мВт/ см2 |
|
Верхний микроскоп: |
С раздельными областями наблюдения с двумя объективами (доступны 3.6х, 4х, 5х, 10х, 20х объективы) 2 позиционный суппорт объективов Суммарное увеличение: 130х-725х Диапазон перемещения объективов: по оси X: 30 – 150 мм (опционально - минимум 8 мм) по оси Y: ± 70 мм по оси Z: максимум ± 5 мм Опционально: совмещение при больших зазорах для расстояний до 500 мкм |
|
Нижний микроскоп: |
· С раздельными областями наблюдения с двумя объективами (доступны 3.6х, 4х, 5х, 10х, 20х объективы) Диапазон перемещения объективов: по оси X: 30 – 100 мм (опционально - минимум 8 мм) по оси Y: ± 12 мм по оси Z: максимум ± 5 мм Суммарное увеличение: 160х-960х |
Режимы экспонирования:
|
100 мм |
150 мм |
|
|
Мягкий контакт: |
0.01 – 0.38 Н/см2 |
0.01 – 0.17 Н/см2 |
|
Жесткий контакт: |
0.01 – 0.38 Н/см2 |
0.01 – 0.17 Н/см2 |
|
Вакуумный контакт: |
0.01 – 7 Н/см2 |
0.01 – 7 Н/см2 |
|
Микрозазор: |
Расстояние экспонирования 0 – 100 мкм |
|
